 编号:86
编号:86 查看:1945
查看:1945
MOSFET你不了解的后端工艺(BGBM)
发布时间:2023-12-19
◆ 半导体制造流程

◆ MOSFET正面金属化工艺(FSM)
正面金属化工艺是MOSFET晶圆减薄前的一个关键工艺,由于MOSFET具备高开关切换速度,低输入阻抗与低功率耗损之特性,必须承受大电流,因此在工艺上,必须使用铜夹焊接 (Clip Bond)加大电流路径来取代金属打线焊接(Wire Bond),藉此降低导线电阻与RDS(on)(导通阻抗)。
而正面金属化工艺的目的,就是藉由溅镀或化镀方式形成UBM,接着做铜夹焊接 (Clip Bond),以降低导线电阻。
在使用夹焊(Clip Bond)时,由于铝垫上方必须要有凸块下金属层(Under Bump Metallurgy, 下称UBM),来作为铝垫和凸块(Bump)之间的焊接表面(Solder Surface)。UBM的组成金属元素,在溅镀和化镀上各有不同,溅镀使用钛/镍钒/银(Ti/NiV/Ag);化镀则是使用镍金/镍钯金(NiAu/NiPdAu)。
◆ 化学镀
客户的晶圆在完成入站检验后 (IQC),按照客户指示之种类及厚度,进入化学镀机沉积金属。首先,藉由化学镀机内事先定义好的程序,自动进行去油清洁后 (Degreasing),对铝垫(Al Pad)表面进行微蚀刻 (Etching);接着,进入两次的锌活化程序 (Zincation*2):第一次锌活化后,进行锌微蚀刻,再进行第二次锌活化;最后,进行化学镀镍钯金的程序 (Ni / Pd / Au) 后,并出站检验 (OQC)。

◆ 案例分享(化学镀沉积)
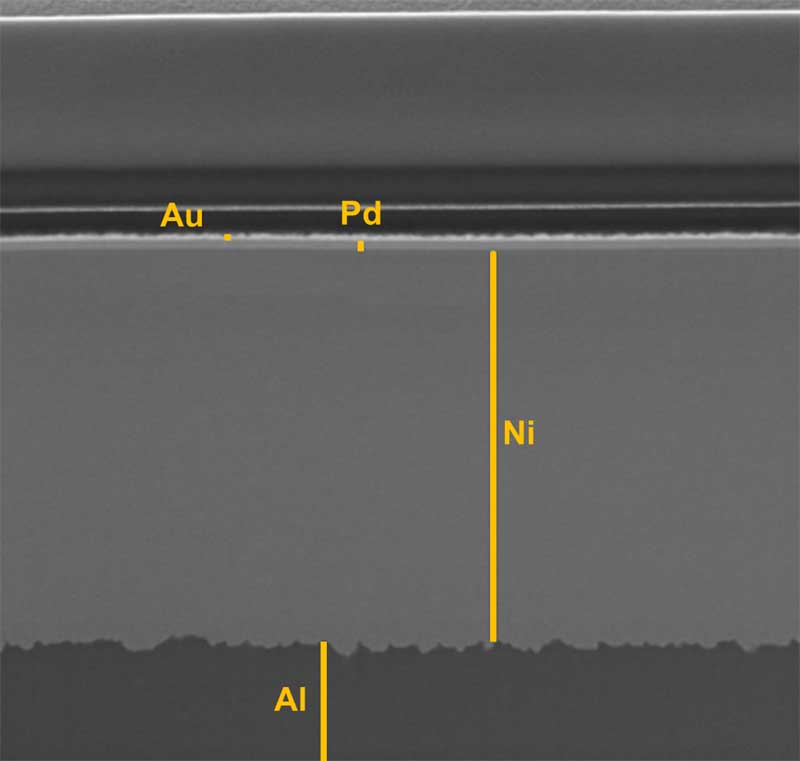
在铝垫上以化学镀沉积镍钯金 (ENEPIG),铝垫 (Al Pad) 表面无大量损耗
◆ 应用范围
● 金属组合:镍钯金 Ni / Pd / Au (ENEPIG)及镍金 Ni / Au (ENIG)
● 适用Al、AlCu、 AlSiCu、AlSi Pad
◆ 正面金属渐射沉积工艺
客户的晶圆在完成入站检验 (IQC) 后,按照客户指示之种类及厚度,进入溅射机沉积金属(Sputtering)。完成金属沉积后,以客户指定之光罩图形,搭配黄光机台定义要留下的金属图形后 (PHOTO),进行金属蚀刻 (Metal Etching);最后,将光阻去除 (PR Strip) 后,出站检验(OQC)。

◆ 案例分享(正面金属渐射沉积)
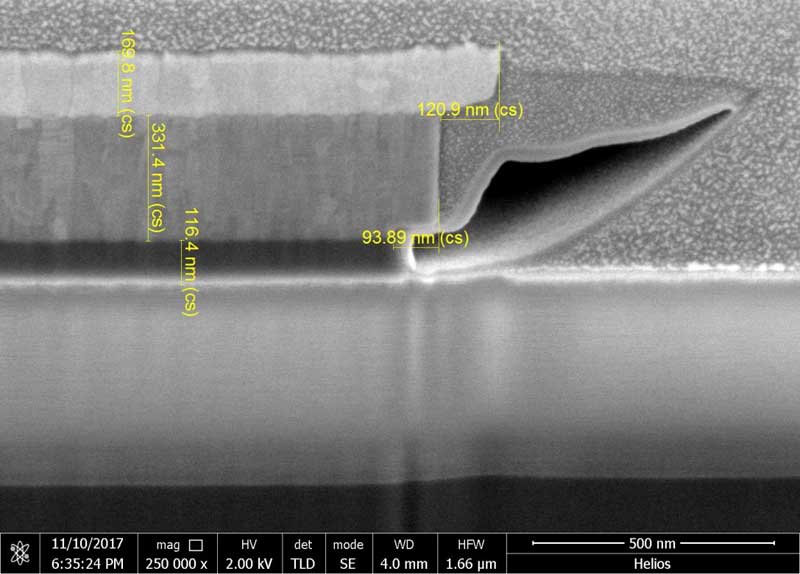
以金属溅射沉积(Metal Sputtering Deposition) 完成的正面金属工艺,镍钒及钛的退缩(Under Cut) 极小,达0.22um
◆ 应用范围
● 金属组合:钛/镍钒/银 (Ti/NiV/Ag)
● 钛/镍钒/银 (Ti/NiV/Ag) 成长的均匀性极佳
● 极小Under Cut
深圳市深鸿盛电子有限公司是一家专业的半导体功率器件设计公司,专注于半导体功率器件的研发、制造、技术服务与销售。
HI-SEMICON 主要产品有:多层外延超结MOS(Multi-epi CoolFET )、平面MOS、中低压SGT&Trench MOS、碳化硅MOS、碳化硅肖特基二极管(SiC Schottky Diodes)、超快恢复整流二极管(FRED)、SiC模块等,产品广泛应用于各类消费电子、工业控制、汽车电子、家电、智能装备、通讯电源、轨道交通、光伏逆变、新能源充电桩及储能BMS等领域。
总部地址:深圳市南山区月亮湾大道前海诚进大厦402-404室
邮编:518000
电话:0755-88327180
传真:0756-33327190






.jpg)